
1. 案例背景
X公司出现了一批某型号的手机,品质部门反馈手机软板上SMT元件焊接后易脱落,不良率约为3.3%,PCB焊盘上的断裂面在电子显微镜下观察,表现为平整的断裂面。
2.分析方法简述
A.样品外观照片:
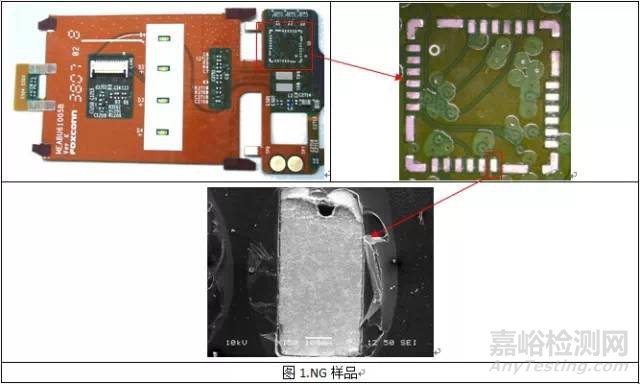
B.确定了试验方案后我们针对失效样品做了如下的分析:

备注:AuSn4是一种很脆的金属间化合物,是引起“金脆”现象的主要原因﹐对焊点强度影响较大。
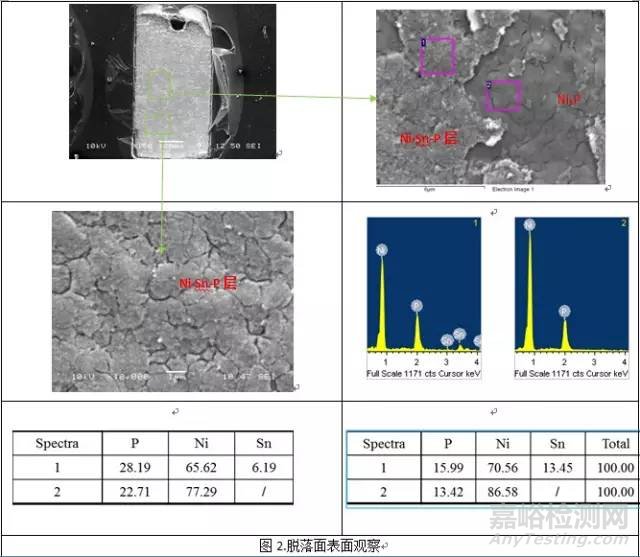
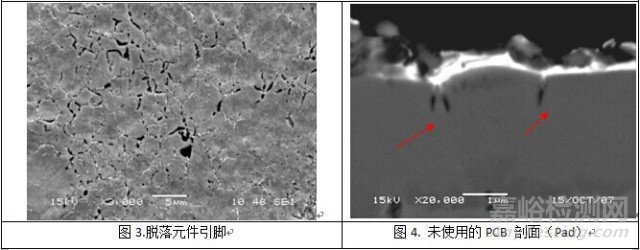

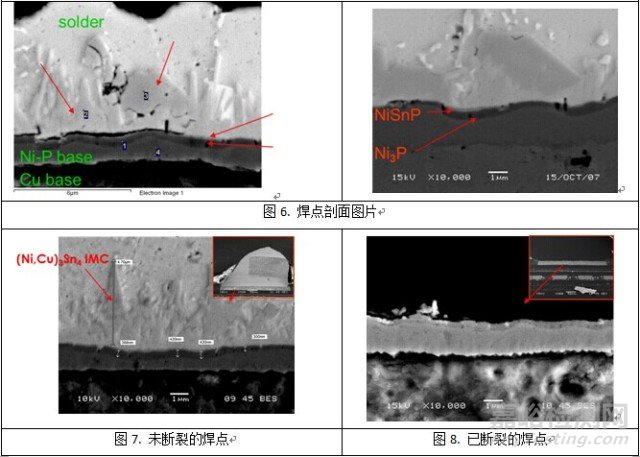
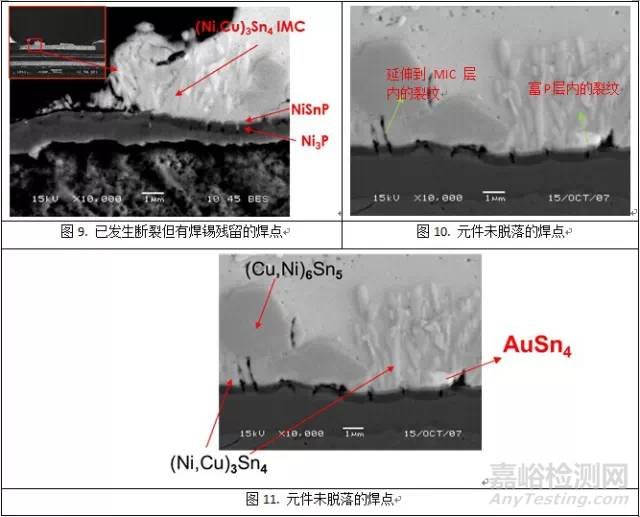
C.找到导致焊点易脱落的失效机理后,与该公司工艺人员沟通后,得知其焊接时的TOL长达70s,但由于该款产品即小又薄,且零部件布局密度也较低。这样过长的TOL时间导致焊点IMC结构粗大、松散,富P层过厚并形成了Ni-Sn-P层。
3. 分析与讨论
由以上分析结果可以导致焊点易脱落的原因是多方面因素造成的,总结如下:
a).失效元件的焊点形成了大结构的(Ni,Cu)3Sn4IMC,过多的易脆的IMC的生成会导致焊接强度偏低,在受到应力时焊点*在IMC于PAD上的富P层之间开裂。
b).同时焊点的富P层也很厚,富P层内由于Ni扩散而形成的裂缝会降低焊点的强度。
c).焊点焊接界面附近残留的AuSn4合金(可能是PCB PAD金层过厚或焊点锡量过少不利Au的熔融导致),这种合金可能会引起“金脆”,对焊点强度也有一定影响。
d).焊点在富P层与(Ni,Cu)3Sn4IMC间形成了对焊接强度危害较大的Ni-Sn-P合金,焊点的断裂主要发生在Ni-Sn-P层附近。
4.结论
减少回流时间到45s~55s,以抑制Ni-Sn-P层的形成,减少焊点IMC、富P层厚度。改善PCB表面处理制程,杜绝“黑镍”现象发生。减薄PCB PAD金层厚度或增加焊点锡量以防止“金脆”发生。
备注:回流时间越长会生成越多的Ni-Sn-P合金。